活動・成果
共同・受託研究等
知的財産
組織
製造技術
理学部 数学プログラム
劉研究室

| 専門分野 | 数理モデルの誤差解析、シミュレーション、抵抗率測定、四探針法、補正係数の計算 |
|---|---|
| キーワード | 抵抗率測定、四探針法、補正係数の計算、測定誤差の解析、シミュレーション |
四探針法は、半導体材料の抵抗率測定法として半導体材料の製造工程において最も広く用いられています。四探針法に使用された山下法などの補正計算方式は、オリフラの周辺やウェハーのエッジ付近では補正計算の誤差が大きいという欠点があります。
本研究開発では、有限要素法を用いたシミュレーションによって、四探針法の新しい補正係数計算方法を開発しました。当該補正係数の計算方法により、従来の方法で扱い難い非定型形状の半導体材料や、ウェハーのエッジ付近の抵抗率の測定に対して、高精度な補正係数の算出ができます。
本研究で開発した方法の特徴:
>高精度 補正係数の計算値と理論上の厳密値の相対誤差を0.02%以下に抑える。
>広い測定範囲に対応 エッジから1mm以上離れている範囲で抵抗率測定に対応できる。
>様々な形状に対応 ウェハーのオリフラ、ノッチとエッジ断面の形状に対応可能。
>大口径(45cm以上)ウェハーの場合、エッジ付近も測定でき、材料の有効利用が可能となる。
>四探針法以外新たな測定方法の補正係数の算出が可能。
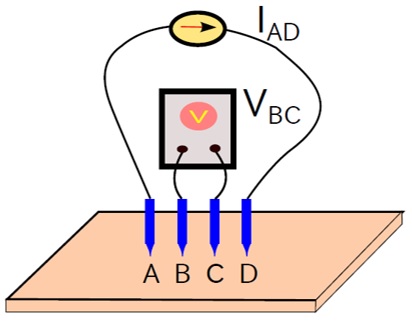
四探針法による抵抗率の測定

オリフラのあるウェハー
| 関連する知的財産論文等 | 劉雪峰、4 探針法による半導体材料抵抗率の高精度な測定について、応用数理学会2016年度年会論文誌 劉雪峰、半導体の抵抗率測定法の開発に現れるいくつかの応用数学の問題、応用数理学会2018年度年会論文誌 半導体抵抗率測定の補正係数のオンライン計算サービス: http://hpc.xfliu.org/R/ |
|---|
抵抗率測定に限らず、様々な測定分野(例えば、静電容量式距離測定)に使用される補正係数について、数理モデルの解析とシミュレーションによって、正しく算出できます。
・半導体関連などの製造・測定分野で、従来経験だけで扱いにいくい測定方法の見直しを検討している企業を期待しています。
